QR कोड

हाम्रो बारेमा
उत्पादनहरू
हामीलाई सम्पर्क गर्नुहोस


फ्याक्स
+86-579-87223657

इ-मेल

ठेगाना
वांग्दा रोड, जियांग स्ट्रीट, वुई काउन्टी, जिन्हुआ शहर, झेजियांग प्रान्त, चीन
अर्धवान्डक्टर्स र fpd प्यानल प्रदर्शन, पातलो फिल्महरूको तयारी महत्त्वपूर्ण प्रक्रिया हो। तल पातलो फिल्महरू तयार पार्न धेरै तरिकाहरू छन् (TF, पातलो फिल्म), निम्न दुई विधिहरू सामान्य छन्:
● CVD (रासायनिक वाष्प निक्षेप)
● PVD (भौतिक वाष्प जम्मा)
ती मध्ये, बफर तह/सक्रिय तह/इन्सुलेट तह सबै PECVD प्रयोग गरेर मेसिनको च्याम्बरमा जम्मा गरिन्छ।
● विशेष ग्याँसहरू प्रयोग गर्नुहोस्: SIH4 / NH3 / n2o को स्थापनाका लागि SH3 / NH3 / N2o प्रयोग गर्नुहोस्।
● केही CVD मेशिनहरू एच 2 प्रयोग गर्न आवश्यक छ क्यारियर गतिशीलता बढाउन।
● NF3 एक सफा गर्ने ग्यास हो। तुलनामा: F2 अत्यधिक विषाक्त छ, र SF6 को हरितताहाउस प्रभाव NF3 को भन्दा उच्च छ।
सेमीकन्डक्टर उपकरण प्रक्रियामा, सामान्य SiO2/Si/SiN बाहेक, त्यहाँ W, Ti/TiN, HfO2, SiC, आदि पातलो फिल्महरूका थप प्रकारहरू छन्।
यो पनि कारण हो कि त्यहाँ विभिन्न प्रकारका पातलो फिल्महरू बनाउनको लागि अर्धचालक उद्योगमा प्रयोग हुने उन्नत सामग्रीहरूको लागि धेरै प्रकारका पूर्ववर्तीहरू छन्।
1. CVD को प्रकार र केहि पूर्ववर्ती ग्यासहरू
2। CVD र फिल्म क्वालिटीको आधारभूत संयन्त्र
CVD एक धेरै सामान्य अवधारणा हो र धेरै प्रकारमा विभाजित गर्न सकिन्छ। साधारण व्यक्तिहरू हुन्:
● म षडयंड: प्लाज्मा परिष्कृत CVD
● LPCVD: कम चाप CVD
● ALD: आणविक तह जम्मा
● Mocvd: धातु-जैविक CVD
CVD प्रक्रियाको बखत, प्रिराकरको रासायनिक बन्धन रासायनिक प्रतिक्रिया अघि भाँच्नु आवश्यक छ।
रासायनिक बन्डहरू तोड्नको लागि उर्जा तातोबाट आउँदछ, त्यसैले कोठाको तापक्रम तुलनात्मक रूपमा उच्च हुनेछ, जुन प्यानलको सब्सट्रेट (लचिलो स्क्रिनको pi सामग्रीको अनुकूल छैन। तसर्थ, अन्य ऊर्जालाई इनपुट गरेर (प्लाज्मा, आदि गठन गर्न केही प्रक्रियाहरू पूरा गर्न को लागी केही प्रक्रियाहरू पूरा गर्न को लागी केही प्रक्रियाहरू पूरा गर्न को लागी थर्मल बजेट पनि कम हुनेछ।
तसर्थ, A-Si:H/SiN/poly-Si को PECVD निक्षेप FPD डिस्प्ले उद्योगमा व्यापक रूपमा प्रयोग गरिन्छ। सामान्य CVD पूर्ववर्ती र चलचित्रहरू:
Polycrystalline सिलिकन/एकल क्रिस्टल सिलिकन SiO2 SiN/SiON W/Ti WSi2 HfO2/SiC
CVD को आधारभूत संयन्त्रको चरणहरू:
1 प्रतिक्रिया प्रिरासर ग्यास कोठामा प्रवेश गर्दछ
2. ग्याँस प्रतिक्रिया द्वारा उत्पादित मध्यवर्ती उत्पादनहरू
।। ग्यासको मध्यवर्ती उत्पादनहरू सब्सट्रेट सतहमा फैलियो
।। सब्सट्रेट सतह र फरक
।। रासायनिक प्रतिक्रिया सब्सट्रेट सतह, अवैधता / टापु गठन / फिल्म गठन
6. उपउत्पादनहरू डिसोर्ब गरिन्छ, भ्याकुम पम्प गरिन्छ र उपचारको लागि स्क्रबरमा प्रवेश गरेपछि डिस्चार्ज गरिन्छ।
माथि उल्लेख गरिएझैं सम्पूर्ण प्रक्रियामा बहु कदमहरू समावेश छन् जस्तै बहु कदमहरू समावेश छन् जुन। समग्र फिल्म गठन दर धेरै कारकहरू द्वारा प्रभावित छ, जस्तै तापमान / दबाव / प्रतिक्रियाको प्रकारका प्रकारहरू। डिफ्यूजनसँग भविष्यवाणीको लागि एक प्रसार मोडेल छ, सोखनाको एक शोषण सिद्धान्त छ, र रासायनिक प्रतिक्रियामा प्रतिक्रिया गतिविज्ञान सिद्धान्त छ।
सम्पूर्ण प्रक्रियामा, सब भन्दा बढीको कदमले सम्पूर्ण प्रतिक्रिया दर निर्धारण गर्दछ। यो परियोजना व्यवस्थापनको महत्वपूर्ण मार्गको तरीकासँग समान छ। सबैभन्दा लामो गतिविधि प्रवाहले सब भन्दा छोटो परियोजना अवधि निर्धारण गर्दछ। अवधि यस बाटोको समय कम गर्न संसाधनहरू विनियोजन गरेर सर्ट गर्न सकिन्छ। त्यसैगरी, CVD ले सम्पूर्ण प्रक्रिया बुझेर फिल्म निर्माण दरलाई सीमित गर्ने कुञ्जी बाधा पत्ता लगाउन सक्छ, र आदर्श फिल्म निर्माण दर प्राप्त गर्न प्यारामिटर सेटिङहरू समायोजन गर्न सक्छ।
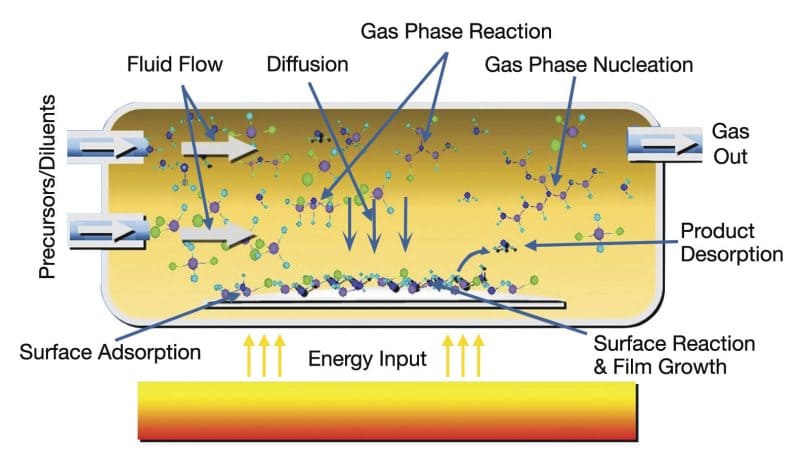
केहि फिल्महरू सपाट हुन्छन्, केहि प्वाल भरिन्छन्, र केहि ग्रुप भरिएका छन्, धेरै फरक प्रकार्यहरूको साथ। वाणिज्यिक CVD मेशिनहरू आधारभूत आवश्यकताहरू पूरा गर्नुपर्दछ:
● मेशिन प्रशोधन क्षमता, जम्मा दर
● एकरूपता
● ग्यास चरण प्रतिक्रियाहरूले कणहरू उत्पादन गर्न सक्दैनन्। ग्यासले चरण चरणमा कणहरू उत्पादन गर्न असम्भव छ।
केही अन्य मूल्याङ्कन आवश्यकताहरू निम्नानुसार छन्:
● राम्रो चरण कवरेज
● उच्च पक्ष अनुपात रिक्तताहरू भर्ने क्षमता (अनुरूपता)
● राम्रो मोटाई एक समानता
● उच्च शुद्धता र घनत्व
● कम फिल्म तनाव संग संरचनात्मक पूर्णता को उच्च डिग्री
● राम्रो विद्युतीय गुणहरू
● सब्सट्रेट सामग्रीमा उत्कृष्ट आसंजन



+86-579-87223657


वांग्दा रोड, जियांग स्ट्रीट, वुई काउन्टी, जिन्हुआ शहर, झेजियांग प्रान्त, चीन
प्रतिलिपि अधिकार © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. सबै अधिकार सुरक्षित।
Links | Sitemap | RSS | XML | गोपनीयता नीति |
